Полирование химическое: Электрохимическая полировка металлов: описание процесса
alexxlab | 14.09.2018 | 0 | Разное
Автор perminoviv На чтение 5 мин. Опубликовано
Металлическому изделию можно придать блеск различными способами. Для этого не обязательно использовать специальные покрытия, можно воспользоваться методом полировки. Она может быть механической, например, с помощью наждачных кругов, химической — когда металл погружают в специальный раствор, а также электрохимической. В этом случае сочетается воздействие химических компонентов и электроразрядов, которые запускают определенные реакции или усиливают их. Электрохимическая полировка металлов может быть выполнена и в обычных домашних условиях, если собрать все необходимое оборудование.
Описание процесса
Во время электрохимического полирования обрабатываемая поверхность металла приобретает зеркальный блеск. Также уменьшаются имеющиеся шероховатости. Процесс происходит следующим образом:
- Деталь считается анодом, то есть, электродом, несущим положительный заряд. Ее необходимо поместить в ванну со специальным составом.
- Еще один важный компонент — катоды, которые необходимы для осуществления реакции.
- В результате воздействия протекает реакция, и происходит растворение. Оно неравномерно, сначала удаляются самые заметные шероховатости, которые выступают над поверхностью больше всего. Одновременно происходит полировка — изделие приобретает зеркальный блеск.
Удаление заметных больших неровностей называется макрополированием, а сглаживание мелких дефектов — это микрополирование. Если эти процессы во время проведения обработки протекают одновременно и равномерно, то изделие приобретает блеск и гладкость. Возможно и такое, что блеск будет получен без сглаживания или наоборот. Два вида полирования не обязательно связаны.
Химическая полировка металла приводит к тому, что на поверхности обрабатываемой детали во время процесса образуется особая пленка. По составу она может быть оксидной или гидроксидной. Если она равномерно охватывает всю поверхность, это создает условия для микрополирования. При этом внешняя часть покрытия, располагающаяся на поверхности, непрерывно растворяется. Чтобы получить возможность провести микрополирование, необходимо обеспечить поддержание равновесия между непрерывным образованием покрытия и растворением, во время работы с деталью толщина слоя должна оставаться неизменной. Это позволит электронам обрабатываемого металла и применяемого состава в процессе взаимодействовать без опасности растворения металлического изделия в агрессивной среде.
Макрополирование тоже напрямую зависит от образующейся пленки. Она покрывает изделие неравномерно, на выступающих неровностях этот слой более тонкий, поэтому они быстрее растворяются, за счет воздействия тока.
СОВЕТ: эффективность общего воздействия полирующего состава можно повысить, если использовать для обработки электролиты, содержащие в своем составе соли слабо диссоциирующих кислот, которые увеличивают общее сопротивление покрытия.
Кроме этого играет роль механическое воздействие, заключающееся в перемешивании. Может уменьшаться толщина пленки или диффузный слой. Некоторые используемые электролиты выполняют свою функцию только при нагреве, также общее правило, которое действует для всех составов — при нагревании снижается нейтрализация, а скорость растворения пленки повышается. Плотность тока и уровень напряжения также входят в число факторов, оказывающих серьезное влияние на процесс. Например, если необходимо провести полировку медных изделий, то для нее подбирается состав с фосфорной кислотой и устанавливается предельный режим тока без образования кислорода. Именно поэтому важно точно соблюдать все необходимые параметры, чтобы добиться качественной полировки.
Оборудование и химикаты
Для работы с различными металлами необходимо подобрать соответствующие электролиты, которые помогут добиться нужного результата:
- Чаще всего применяются составы на основе кислоты различного вида — серной, фосфорной или хромовой.
- Глицерин может быть добавлен для увеличения общей вязкости, если это потребуется.
- Сульфоуреид выступает в роли ингибитора травления.
- Для очистки различных изделий после проведения процедуры могут применяться различные растворители или щелочные средства. Нередко используются составы с поверхностно-активными действующими веществами.
Пропорции создания хим состава
Полировка проводится в специальных ваннах. Важно помнить, что их составляющие относятся к токсичным веществам и опасны для здоровья, особенно если используется нагрев, поэтому обращаться со всеми компонентами необходимо с максимальной осторожностью, соблюдая положенную технику безопасности.
Изделия из цветных или черных металлов можно обрабатывать при помощи универсального состава, который окажет необходимое воздействие. Для этого следует добавить все компоненты, соблюдая пропорции. Ортофосфорная кислота составляет основу — 65%. Серной кислоты должно быть 15% и 14% обычной воды. Хромовый ангидрид занимает 6%.
Нержавеющую сталь можно полировать схожим составом, только воды в нем должно быть 13%, а еще следует добавить глицерин в соотношении 12%. Детали могут находиться в ванне до получаса, хотя штампованным изделиям требуется меньше времени для обработки.
Область применения
Химическая полировка металла используется, чтобы придать поверхности зеркальный блеск. Такое действие может быть направлено на придание деталям более привлекательного облика, если они находятся на виду и являются частью какой-то конструкции. Помимо эстетического назначения, полировка служит не только для красоты. С ее помощью можно избавить деталь от неровностей и шероховатостей, а также защитить от воздействия ржавчины, кислот и различных атмосферных явлений.
Преимущества и недостатки
Разные виды полировки имеют свои особенности, у электрохимической также есть плюсы и минусы:
- Этот способ благоприятно влияет на все свойства стали, увеличивая устойчивость к воздействию коррозии, а также облегчая проведение вытяжки и штамповки. Именно поэтому полировку такого типа часто используются как в лабораторных исследованиях, так и непосредственно для проведения различных работ в промышленности.
- Электрохимическая полировка является более дешевым и быстрым способом обработки металлических изделий. Если механический метод занял бы несколько часов, то с воздействием химикатов и электричества можно закончить дело за несколько минут, получив качественный результат.
- Полировка с электрохимическим воздействием незаменима при работе со сложными деталями, которые имеют различные полости и отверстия.
Химическая полировка металлов кроме преимуществ, имеет некоторые недостатки. Практически каждый существующий металл требует для проведения работы с ним специального состава, поэтому для разных изделий необходимо делать индивидуальные растворы. Также важно правильно подобрать соотношение компонентов, температуру нагрева, плотность тока — от этого напрямую зависит качество полученного результата. Перед проведением такой обработки может потребоваться предварительное механическое шлифование. Кроме того, процедура требует повышенного расхода электроэнергии. Однако при определенных условиях достоинства метода вполне перевешивают его недостатки, позволяя проводить полировку.
Электрохимическая полировка – процедура обработки поверхности заготовки при помощи ее погружения в раствор кислоты под действием электрического тока. Она сглаживает поверхность детали и позволяет производить полирование металлов без использования лакокрасочных покрытий. В результате взаимодействия химических компонентов и электрических зарядов запускаются реакции, придающие изделию зеркальный блеск.


Описание метода
В основе процедуры электрохимического полирования лежит анодное растворение поверхности обрабатываемой заготовки. Во время этого процесса происходит быстрое растворение выступов на поверхности с шероховатым рельефом. Во впадинах детали происходит растворение в замедленном режиме. Шероховатая сторона становится гладкой из-за несбалансированной скорости растворения, что приводит к появлению дополнительного блеска.
Процесс электрохимической полировки детали происходит в несколько этапов:
- Изготовление электролитических ванн, предназначенных для полирования поверхности изделия. В их состав входят универсальные электролиты: ортофосфорная кислота, серная кислота, хромовый ангидрид и вода. При полировке изделий, произведенных из нержавеющей стали, дополнительно используется глицерин. Создание ванн происходит при температуре до 90° C, анодной плотности тока до 80 а/дм2 и напряжении до 8 В. Электролитические ванны, нагретые до высоких температур, представляют опасность для здоровья человека. При попадании растворов на кожные покровы высок риск образования химических ожогов.
- Подготовка заготовки к обработке. Изделия не должны иметь на своей поверхности глубокие рисунки и крупные царапины, не подлежащие электрохимической полировке. Важно, чтобы деталь была произведена из мягких металлов. Данный параметр оказывает влияние на степень эффективно полирования. Чем тверже металл, тем труднее достичь однородной поверхности при сглаживании шероховатых сторон заготовки.
- Взаимодействие детали с растворами электролитов. В этом случае металлическая заготовка выступает в качестве анода – электрода с положительным зарядом, а электролитическая ванна – в роли катода. Время выдержки изделия в растворе зависит от типа материала. Заготовки из алюминия выдерживаются в течение 2 – 3 мин, литые детали из нержавеющей стали – до 30 мин. В результате реакции осуществляется постепенное сглаживание шероховатостей из-за появления гидроксидной или оксидной пленки. Полирование происходит за счет обмена частиц между анодом и электролитом. После завершения электрохимической полировки поверхность заготовки становится однородной и приобретает зеркальный блеск.
Теоретически механизм электрохимической полировки объясняется гипотезой вязкой пленки. В соответствии с гипотезой, полирование детали осуществляется после образования поверхности анода в результате растворения частиц вязкой пленки, в состав которой входят продукты анодного растворения. Пленочная поверхность обладает высокими показателями сопротивления, толщина которой различается на впадинах и выступах заготовки. Из-за разницы величины сопротивления вязкой пленки и способности тока собираться на остриях, на разных участках изделия изменяется скорость растворения шероховатостей. В результате шероховатая сторона полностью сглаживается и приобретает однородную поверхность.


Электрохимическую полировку деталей возможно проводить в домашних условиях. Для этого необходимо приобрести оборудование с валом электромотора и кругами для шлифования или создать электролитическую ванну и изготовить химический раствор из соответствующих веществ.
Если деталь имеет множество больших дефектов, то перед началом электрохимической полировки она подвергается механической обработке при помощи шлифовальной машины с вращающимися кругами.
После завершения этого процесса заготовка помещается в щелочной раствор и подсоединяется к заряженному электроду. Процедура электрохимической полировки включает в себя макрополирование: растворение выступающих вершин большого размера, и микрополирование: сглаживание маленьких поверхностей изделия.
Процесс полировки может быть ускорен при следующих условиях:
- толщина обрабатываемой пленки одинакова на всей поверхности детали;
- перемешивание и повышение температуры электролитов;
- наличие комплексных солей или солей слабодиссоциирующих кислот в составе электролитов;
- увеличение значений напряжения и силы тока.
Эти факторы уменьшают величину поверхностного слоя заготовки, что позволяет производить процедуру полировки за меньший промежуток времени.
Оборудование и материалы
Для электрополировки металла необходимы источники постоянного тока с низкими показателями напряжения и инструменты, для настройки электрического режима. Электролитические ванны должны быть оборудованы нагревателями, поддерживающими температуру химического раствора. Они помещаются в прочную оболочку, располагающуюся на внутренней поверхности ванны, облицованной химическими и теплостойкими материалами.
Для соблюдения техники безопасности в лабораториях для облицовки внутренних конструкций электролитической ванны применяют стеклянные, фарфоровые и керамические материалы. В лабораторных условиях источником тока являются выпрямители, изготовленные из селена или германия. В зависимости от требуемого напряжения возможна установка нескольких выпрямителей.
Для полирования стальных заготовок требуется регулировочное оборудование. Для настройки величины тока в промышленных условиях применяют первичную обмотку трансформатора, соединенного с выпрямителями. С его помощью осуществляется бесступенчатое регулирование тока посредством изменения значений напряжения.
Электрохимическая полировка металлов проводится с применением электролитов, составленных на основе серной, фосфорной и хромовой кислот. Дополнительно добавляется глицерин, увеличивающий суммарную вязкость раствора. Смешивать все электролиты необходимо в правильной пропорции. В следующей таблице представлены соотношения кислот для полирования деталей, изготовленных из разных типов металлов:
| Электролит | Материал заготовки
| |||
| Углеродистая сталь | Нержавеющая сталь | Алюминий | Дюралюминий | |
| Ортофосфорная кислота | 65% | 65% | 70% | 45% |
| Серная кислота | 15% | 15% | – | 40% |
| Хромовый ангидрид | 6% | 6% | 10% | 3% |
| Вода | 14% | 12% | 30% | 11% |
| Глицерин | – | 12% | – | – |
Большинство металлов полируется в фосфорносернохромовом электролите, удовлетворяющем следующим условиям:
- высокие показатели растворимости, что способствует лучшему сглаживанию поверхности полируемой детали;
- длительный срок эксплуатации раствора;
- универсальность электролита;
- безопасен для жизни и здоровья человека.
Важным показателем электролита является его температура. Чем выше этот показатель, тем интенсивнее происходит процесс полирования. Для всех электролитов предусмотрены пределы температур. Если резко понизить данный параметр во время проведения электрохимической полировки, то вязкая пленка уплотнится, что приведет замедлению растворения анодов. В результате полируемая поверхность изделия становится матовой и не приобретает зеркальный блеск.


На равномерность электрохимической полировки оказывает влияние дистанция между электродами в электролите. Оптимальное растворение происходит при расстоянии до 40 мм. При дальнейшем увеличении данного показателя удаляемый слой становится неравномерным. В итоге поверхность детали покрывается темным налетом и становится более хрупкой.
После завершения процесса электрохимической полировки требуются приспособления для очистки электролитической ванны и остального полировочного оборудования. Для этого используются растворители и щелочные средства. В их состав входят активные действующими веществами, очищающими поверхность инструментов полировки от различных видов грязи.
Область применения
Технологию электрохимического полирования активно применяют в промышленности: для обработки деталей арматуры, элементов карбюратора (клапанов для подачи топлива, выполненных из нержавейки), тонких лент, проволок и трубных механизмов. В результате полирования поверхность этих деталей приобретает устойчивость к коррозии и становится более гладкой.
Электрохимическое полирование алюминия и нержавеющей стали применяется в отраслях по производству строительных приспособлений, сверл и крепежных механизмов.
В нынешнее время эта технология активно используется для снятия дефектного слоя с режущих инструментов, использующихся для проделывания отверстий. Электрохимическое полирование вольфрама стало активно внедряться в производстве электронных ламп и электровакуумной техники.
Использование технологии электрохимической полировки практикуется при металлографических исследованиях для диагностики сталей. При помощи этой технологии выявляются трещины, флокены и иные несоответствия в структуре металлов. При обнаружении нарушений производится полировка, удаляющая самые тонкие деформации.
Преимущества и недостатки
Электрохимическая полировка обладает следующими достоинствами:
- Она увеличивает прочность стали и препятствует появлению ржавчине на поверхности металла. Этот вид полировки облегчает процедуру вытяжки и штамповки.
- Она способна смягчать поверхность сложных и утонченных деталей, имеющих дополнительные отверстия или полости с комплексных рисунком.
- Электрохимическая полировка позволяет снизить время полирования поверхности заготовки.
- Благодаря высокой производительности данного вида полирования, во время обработки металла не нарушаются основные конструкции изделия.
- Ускоряет процедуру производства шлифов.
Несмотря на большое количество преимуществ, электрохимическая полировка обладает несколькими недостатками:
- Сложность полирования, обусловленная необходимостью приготовления индивидуального раствора для обработки деталей из разных сталей и регулирования величины подаваемого тока.
- В ней применяются элементы электрополирования, что приводит к повышенному расходу электроэнергии.
- Электрохимическая полировка не способна выровнять поверхность заготовки с большими трещинами или впадинами.
- Как при химполировке, человеку необходимо производить работу с ядовитыми веществами, наносящими вред организму.
- Электрохимическая полировка не требует больших финансовых трат, в отличие от механического полирования, что обусловлено покупкой множества химических растворов и перманентной подачей электричества. Электролит обладает низким сроком эксплуатации, поэтому его необходимо периодически обновлять, что приводит к дополнительных денежным расходам.


Чтобы эффективно использовать технологию электрохимической полировки, нужно соблюдать технику безопасности: работать в спецодежде, правильно настраивать техническое оборудование и осуществлять полировку только с исправными приборами.
Химические технологии полировки | Inoxgrup
Что такое химическая полировка?
Химическая полировка является одним из методов отделки поверхности металла. Процесс растворяет и удаляет утолщения микроскопически неровной поверхности путем погружения компонентов в химическую ванну. По сути, это представляет собой химический процесс травления. По сравнению с поверхностью перед полировкой, неровности уменьшаются и поверхность становится более гладкой.
Различные методы обработки поверхности металла
Существует большое количество методов обработки поверхности металла. Некоторые методы, такие как гальванические технологии увеличивают размеры материала. Термическая обработка (отжиг), пассивирование и травление не изменяют размеры. Химическая полировка и Электрополировка являются примерами технологий, которые уменьшают размеры металла.
Электрополировка против химического полирования
В процессе электрохимической полировки (ЭХП), используется низкое напряжение (V~12v) от источника питания постоянного тока в кислой ванне. Металлическая пластина соединена с катодом (-), а деталь, подлежащая полированию соединена с анодом (+). Когда подается напряжение, происходит электрохимическая реакция, и начинается травление металлической поверхности анода. Электрический заряд выше в местах выступов, тем самым процесс устраняет заусенцы, образующиеся после механической обработки. ЭХП улучшает скорость потока внутри трубы, так как микро полости и шероховатости в трубах могут значительно замедлить скорость потока. Кроме того, образование и рост бактериальных колоний будет устранен. Процесс ЭХП также улучшает коррозионную стойкость металла.
Из-за особенности процесса, электрохимполированию подлежат трубы относительно большого диаметра. Трубы с маленьким внутренним диаметром (<16мм) и изогнутые трубы не могут быть обработаны ЭХП, не возможно достичь желаемых результатов. Кроме того, процесс ЭХП является более сложным, чем ХП.
Преимущества и недостатки различных методов Полировки
Ниже таблица суммирует преимущества и недостатки различных типов методов полировки металлов
| метод | Проблемы | Подходящие приложения |
| Механическая шлифовка | Оставшиеся частицы, и фрагменты остаются на компонентах внутри впадин на поверхности не удаляются. Большое пылевое воздействие на окружающую среду. | Подходит, когда высокий уровень декоративной или гигиенической отделки не требуется. Труд и стоимость оборудования высока. Невозможно отполировать изнутри. |
| Электрохимический | Каждая часть должна быть подвешена и подключена к электродам. Крепление электрода внутри трубы затруднено или не возможно. Требуется нагрев до 70 С и регуляция концентрации раствора. Требуется жесткий экологический контроль и надлежащее нейтрализация сточных вод. | Подходит для относительно больших и простых компонентов Очень низкая эффективность Некоторые компоненты невозможно обработать Некоторые компоненты невозможно заменить химической полировкой |
| Химическая полировка | Любая форма нормально, не нужно подвешивать отдельные части, нет необходимости в электроде. Просто загрузить компоненты в ванну.
Внутренние полости погруженные в химическом растворе становится отполированы.
Требуется, нагрев до 96℃ , нуждается в жестком контроле экологического контроля и надлежащее нейтрализация сточных вод. | Могут быть отполированы внутренние поверхности длинной трубы, из различных компонентов, изогнутые части. Применяется для маленьких и тонких деталей, требующих сверкающей поверхности, деталей не имеющих заусенцев, максимальной чистоты и деталей, которые невозможно отполировать электролитическим способом. Эффективность очень высокая. Вполне возможно заменить Электрополировку, но не наоборот |
Недостатки механической полировки
Механические обработки, такие, как шлифовка, полировка, механическая придают поверхности из нержавеющей стали жесткость. Тому есть несколько причин: наличие посторонних элементы на поверхностях нержавеющей стали вызвано:
(1) поверхностным загрязнением,
(2) физическим или химическим поглощением на поверхности,
(3) образованием нового соединения на поверхности,
(4) чужеродные тела , падающие на поверхность, и влекущие изменения в метаморфический слой во время процесса путем формирования новой структуры поверхности
2. аморфный слой , созданный в связи с изменением структуры решетки. В результате, структура решетки может легко создать деградированный слой:
3. Остаточным поверхностным электростатическим напряжением.
Дефектные поры и остаточные примеси в трубах из нержавеющей стали после галтовки
Удаление стресс-индуцированного упрочненного слоя с помощью химической полировки
Закаленный поверхностный слой, вызванный вышеуказанными причинами может быть удален с помощью химической полировки. Компоненты ХП могут восстановить характеристики исходного материала.
Дополнение ионов наружный слой после механической обработки
Каждый химический элемент в нержавеющей стали расположен в соответствии с его собственным потенциалом валентной связи, образуя подходящую структуру металлической решетки. После механической обработки, полировки, шлифовальные процессы, элементы, расположенные на наружном слое, удаляются и деградируют, и эти дефекты в значительной степени снижают коррозийную стойкость нержавеющей стали, агрессивные среды, легко проникают и поглощаются поверхностью обрабатываемой детали. В результате, чистота и стойкость к коррозии поверхности скомпрометированы, зачастую технические характеристики не отвечают требованиям заказчика.
Сравнение эффективной площади поверхности среди различных труб
| Полировка методы | Шероховатость поверхности | Геометрическая площадь поверхности | эффективная площадь поверхности | Отношение площади поверхности |
| Типичные пластины 2B | 0,20 ~ 0,50 | 16 | 34 | 2,1 |
| Типичная продезинфицировать трубку | 0,20 ~ 0,30 | 16 | 21 | 1,3 |
| Типичная блестящая полированная трубка | 0.10 ~ 0.03 | 16 | 21 | 1,3 |
| 2B Химически полированные гальваническое покрытие трубки | 0.05 ~ 0.20 | 16 | 16 | 1,0 |
После того, как обычная пластина из нержавеющей стали или труба проходит через серию химических процессов, внутренние и наружные поверхности стен будут изменять их характеристики такие как шероховатость, заусенцы, закаленность слоя и т.д. В результате, эффективная площадь поверхности трубы из нержавеющей стали без электролитического или химической полировки гораздо больше ,чем геометрическая площадь поверхности, которая является определяется простым расчетом площади относительно идеальной поверхности. (Смотрите таблицу выше)
шероховатость поверхности и вызывает слипание заусенцев и адсорбцию мелких частиц, замедление скорости потока среды, засорение трубки, рост бактериальной колонии и многих других нежелательных характеристик. Электролитический (EP) или процесс химической полировки (CP) должны быть использован для удовлетворения высоких требований высокоточных технологий изготовления оборудования в.
Cr / Fe, изменение содержания поверхностного слоя 316L (V / V)
Для ASIS304 / 316 / 316L нержавеющей стали, типичное отношение Cr / Fe, составляет около 0,4. Поскольку молекулы Fe являются более активными, они более склонны вызывать химическую реакцию с внешними веществами и подвержены коррозии нержавеющей стали; химические свойства элемента Cr являются более стабильными, чем соединения Fe и являются более устойчивыми к воздействию агрессивных растворов. После химической полировки, поверхностные элементы, отношение Cr / Fe, достигает 1,0 или выше, и более высокое содержание Cr элемента в поверхностном слое повышает коррозионную стойкость и характеристики стали становятся существенно выше.
| Перед химической полировки | После химической полировки | Высокие стандарты чистоты | Ультра высокиестандарты чистоты |
| ≦ 0,4 ( 0,8 ) | ≧ 3,0 ( 4,0 ) | ≧ 1,0 ( 2,0 ) | ≧ 3,0 (4,0) |
отношение Cr / Fe, (стандарты соответствуют нержавеющей стали)
Изменение характеристик стойкости к коррозии после химической полировки
Шероховатость поверхности Изменение
Изменение поверхности после химической полировки (100х)
Сравнение поверхности из нержавеющей стали после механической полировки (слева) и химической полировки (справа). 20 * 3500
По материалам зарубежных изданий Ansing Engineering.
Химическая полировка металла
При химическом полировании воздействие раствора на металл сочетается с действием гальванических пар на его поверхности, что вызывает образование пассивирующей оксидной пленки. Непосредственным результатом химического полирования является сглаживание микронеровностей и образование блеска поверхности с одновременным растворением верхнего слоя. Увеличение блеска связано с предотвращением травления металла вследствие образования на его поверхности пассивирующей окисной пленки, которая возникает под влиянием взаимодействия обрабатываемого металла с компонентами раствора. Однако электрохимическая полировка приводит к получению лучшего блеска поверхности чем при химической.
Качество полированной поверхности зависит от соотношения скоростей формирования пленки и ее растворения в жидкости. Преобладание первой приводит к оксидированию, второй — к травлению металла. Наибольший блеск поверхности достигается при минимальной толщине оксидной пленки, которая должна быть достаточной для предотвращения травящего действия раствора на металл, а это возможно при равенстве скоростей процессов формирования и химического растворения образующейся окисной пленки. Толщина пленки при химическом полировании меньше, чем при электрохимическом. Это объясняет меньшую эффективность сглаживания микронеровностей и повышение блеска поверхности металла.
Положительные результаты полирования нержавеющих аустенитных сталей типа 12Х18Н10Т достигаются в растворе следующего состава: серная кислота — 34%, соляная кислота — 6,5%, азотная кислота — 4,5%, хлористый натрий — 0,5%, вода — 54%, краситель кислотный черный 3М — 0,5%. Корректирование раствора состоит в периодическом добавлении воды и азотной кислоты. Обработку проводят в течение 3–10 минут при температуре 70–75оС.
С увеличением содержания в растворе солей железа время обработки увеличивается до 15–20 минут. Качество поверхности при химическом полировании зависит от объемной плотности загрузки деталей в ванне. При слишком большой загрузке возникает неравномерность обработки поверхности, возможно ее травление и образование других дефектов вследствие затрудненного доступа раствора к поверхностям изделий.
После химического полирования детали необходимо тщательно промыть в проточной воде и высушить. Целесообразно проводить химическое пассивирование полированных изделий. Следует отметить меньшие трудоемкость и энергоемкость химического полирования по сравнению с механическим. Однако процесс химического полирования сопряжён со следующими недостатками:
- Технологическая сложность
- Высокий процент брака
- Токсичность и пожароопасность
- Коррозия оборудования
- Дорогостоящая утилизация отходов.
Электрохимическая полировка изделий. Технологический процесс электроплазменной, электролитической и химобработки металл для придания блеска изделию.
Электрохимическая полировка – это процесс обработки поверхности детали путем погружения ее в кислотный раствор. Металлическое изделие подключается к положительно заряженному аноду, и через электролит пропускается ток с напряжением 10–20 В. В результате металл покрывается оксидной или гидроксидной пленкой, под которой происходит полировка путем сглаживания выступающих микронеровностей. Примерно такой же эффект дает химполировка, но здесь заготовки не подвергаются влиянию электрического тока.
Качество работы зависит от однородности материала. Полирование чистых металлов приводит к получению гладкого блестящего изделия. Полировка сложных сплавов не дает такого результата. По окончании работы обработанная поверхность повышает свою чистоту шероховатости на 2 класса.
Полирование деталей ведется только после их визуального осмотра. Не допускается наличие на них глубоких царапин или раковин, поскольку такие дефекты не устраняются в процессе полировки. Оптимальным вариантом является работа с цилиндрическими деталями. Плоские заготовки хуже поддаются полировке.
По окончании процедуры изделия приобретают ряд положительных качеств: у них увеличивается коррозионная стойкость, повышается прочность поверхностного слоя и понижается коэффициент трения.
Технология электрохимического полирования металла
При электрополировке металла его поверхность становится блестящей. Технологический процесс состоит из ряда операций:
- Предварительно заготовка подвергается механической обработке с целью доведения шероховатости поверхности до 6–7 класса.
- Промывка для удаления грязи.
- Обезжиривание.
- Подсоединение к положительно заряженному электроду.
- Электрохимическое полирование.
- Промывка в щелочной среде с целью устранения кислотных остатков.
- Сушка. Для этого используется горячий воздух или опилки.
- Выдержка деталей в горячем масле, подогретом до температуры 120 °C.
При полировке происходит устранение неровностей с поверхности детали. Поэтому любой процесс сопровождается:
- Макрополированием. При этом идет растворение крупных выступающих вершин.
- Микрополированием. Сглаживаются мелкие неровности.
Погружаемое в электролит изделие покрывается оксидной пленкой, которая является защитной средой между металлом и электролитом. В продолжение всего процесса она постоянно растворяется и образуется вновь. Правильность технологического процесса заключается в том, чтобы ее толщина оставалась стабильной.
Непосредственно под пленкой происходит полировка металла. Осуществляется она за счет обмена электронами и ионами между анодом и электролитом. Толщина формируемой пленки всегда меньше на выступающих частях вершин неровностей. Именно здесь и происходит усиленное растворение металла. В углублениях слой пленки толще, и здесь обмен заряженных частиц уменьшенный.


Образование вязкой пленки толще во впадинах неровностей
Существуют другие факторы, влияющие на скорость полирования поверхности:
- перемешивание электролита;
- повышение его температуры;
- увеличение силы тока и напряжения.
Все эти факторы уменьшают поверхностный слой, что ускоряет полировку.
Для каждого изделия существует свой временной режим. В зависимости от продолжительности процедуры пропорционально увеличивается снимаемый слой металла. Этого не следует допускать, потому что шероховатость поверхности, выйдя на свой уровень, остается неизменной. Происходит ненужное растворение слоя изделия, что не оказывает влияния на качество поверхности.
Электролитно-плазменное полирование
Во время электролитно-плазменного полирования наблюдаются схожие процессы. Однако тут в качестве среды используются растворы солей аммония. Под воздействием высокого напряжения 200–350 В на поверхности детали, которая является анодом, образуется парогазовая оболочка. Формируется она за счет вскипания электролита. Через нее постоянно протекает электрический ток, вызывая появление плазменных разрядов, которые оказывают влияние на сглаживание поверхности. В результате время полировки составляет до 5 мин., а устранение небольших заусенцев – несколько секунд.
Важным условием является поддержание высокой температуры химической среды. Она необходима для создания условий пленочного кипения. Однако и превышать верхний предел нельзя. Например, для низкоуглеродистой стали интервал температур составляет 70–90 °C. За пределами этого интервала снижается качество полировки.


Электроплазменное полирование
Отличия электрополирования от химического
Электрополирование, как и электроплазменная обработка, отличается от химического процесса тем, что через электролит подается электрический ток.
При химическом полировании изделие опускается в емкость с химическим раствором кислоты или щелочи. Здесь происходит растворение поверхностного слоя. Это сопровождается бурным кипением содержимого сосуда. Деталь приобретает нужную шероховатость за несколько секунд. В отличие от электрополирования такой метод менее затратный. Здесь не требуется сложного оборудования. Но присутствуют и недостатки:
- Сложность контроля над протеканием процесса.
- Без применения электрического тока качество получаемого изделия ниже. У него отсутствует блеск. Поэтому такому способу обработки больше подвергаются изделия из цветного металла, имеющие сложную конфигурацию, которым не предъявляется высоких требований.
Применяемое оборудование и материалы
В качестве оборудования для электрополировки применяются ванны. Технология схожа с хромированием деталей.


Конструкция ванны для электрополирования
Ванна имеет следующую конструкцию:
- Наружный корпус.
- Внутренний корпус.
- Внутренняя часть ванны облицовывается термостойким материалом, способным противостоять химической среде. Применяется эмаль марки ЛК-1, фарфор, жаростойкое стекло, керамика.
- Электронагреватели.
- Между корпусами располагается водяная рубашка. Она необходима для регулировки температуры. На первой стадии подготовки электролита он нагревается до 120 °C. Рабочая же температура составляет 70–80 °C.
- Подключаются трансформаторы с выпрямителями. С их помощью идет регулирование подачи электрического тока.
Ведется подбор электролита, который должен отвечать следующим характеристикам:
- безопасностью в процессе применения;
- хорошей способностью для качественного сглаживания поверхности металла;
- длительностью работы;
- возможностью полировки разных металлов.
Исследования показали, что оптимальным составом является смесь фосфорной кислоты, серной и хромового ангидрида. Использование такого электролита позволяет вести полировку сталей как инструментальных, так и легированных. Обработке поддаются медь, алюминий, а также нержавейка.
Присутствие кислот позволяет вести контроль над плотностью электрического тока. Фосфорное соединение его понижает, а серная кислота повышает. За счет правильного формирования концентрации смеси можно оптимально наладить проведение процесса полирования.
Остались вопросы? Обязательно задайте их в комментариях к статье!
Я допер естественно посмотреть ту тему. 🙂
Вот еше:
Элeктpoxимичecкaя пoлиpoвкa cтaли
Элeктpoпoлиpoвaниe cтaлeй являeтcя нaилучшим видoм элeктpoxимичecкoгo aнoднoгo тpaвлeния. Этoт пpoцecc oбъeдиняeт oпepaции удaлeния кoppoзии, cглaживaния пoвepxнocти и пpидaния eй блecкa, пaccивиpoвaния, a тaкжe пoвышeния пpoчнocти cцeплeния гaльвaничecкиx пoкpытий c oбpaбoтaннoй пoвepxнocтью.
Слeдуeт лишь учитывaть, чтo нaчaльнaя чиcтoтa oбpaбoтки дoлжнa быть нe нижe 7—8-гo клaccoв для тoгo, чтoбы, кpoмe пoлучeния блecкa, нaблюдaлcя тaкжe эффeкт cглaживaния пoвepxнocти. Углepoдиcтыe и низкoлeгиpoвaнныe cтaли элeктpoпoлиpуют пepeмeнным тoкoм пpoмышлeннoй чacтoты в элeктpoлитe cocтaвa, % (пo мacce): 96,5 opтoфocфopнoй киcлoты (p =1,54 г/cм3), 2,0 тexничecкoй щaвeлeвoй киcлoты 1,5 клeя cтoляpнoгo в плиткax. Рaбoчaя тeмпepaтуpa 15—30°С плoтнocть тoкa 15—20 А/дм2. Выдepжкa зaвиcимocти oт cocтoяния пoвepxнocти cocтaвляeт 1-5 мин. Пepeд cocтaвлeниeм элeктpoлитa клeй и щaвeлeвую киcлoту pacтвopяют oтдeльнo. Элeктpoдaми cлужaт caми дeтaли, зaвeшeнныe нa штaнгax тpexфaзнoгo или двуxфaзнoгo пepeмeннoгo тoкa нaпpяжeниeм 12—15 В… Для aнoднoгo пoлиpoвaния углepoдиcтыx cтaлeй пocтoянным тoкoм пpимeняют элeктpoлит cocтaвa, % (пo мacce): 65 opтoфocфopнoй киcлoты (p=1,67 г/cм3), 20 cepнoй киcлoты (p=1,84 г/cм3) и 15 вoды (oбщee coдepжaниe). Ингибитop ПБ-5 ввoдят в кoличecтвe 5% oт oбъeмa cмecи киcлoт, oн pacтвopяeтcя мeдлeннo пpи пepeмeшивaнии (в тeчeниe двуx cутoк). Рaбoчaя тeмпepaтуpa <15—25°С, кopпуc вaнны имeeт pубaшку для вoдянoгo oxлaждeния. Анoднaя плoтнocть тoкa >20 А/дм2, выдepжкa дo 20 мин. пpи нaпpяжeнии дo 30 В. Свинцoвыe кaтoды пepиoдичecки зaчищaют.
Пoлиpoвкa xpoмиcтыx нepжaвeюшиx cтaлeй.
Фocфopнaя киcлoтa (h4PO4) 65-75%
Хpoмoвый aнгидpид (CrO3) 12-10%
Сepнaя киcлoтa 20-12%
Рaбoчaя тeмпepaтуpa 65-70°С, пpи d = 1,74 г/cм3. Анoднaя плoтнocть тoкa 50-60 А/дм2 c выдepжкoй 4-5 мин.
Сepнaя киcлoтa, d = 1,84 100 г/л
Глицepин 100 г/л
Рaбoчaя тeмпepaтуpa 18-30°С, в тeчeниe 5-10 мин. пpи aнoднoй плoтнocти тoкa 10А для cтaли 12X18h20T и 12-15А для 08Х13. Глицepин мoжнo зaмeнить дeкcтpинoм или кpaxмaлoм в тoм жe кoл-вe.
Вce вышeпpивeдeнныe cocтaвы тexнoлoгичecки cлoжны, эти двa дoвoльнo пpocтыx peцeптa, мoжнo пoпpoбoвaть в дoмaшниx уcлoвияx
Фocфopнaя киcлoтa (h4PO4, d = 1,55 73%) 88%
Хpoмoвый aнгидpид (CrO3) 10%
Вoдa 2%
Пepeд пoлиpoвкoй элeктpoлит нaгpeвaют в тeчeниe чaca дo 100-120°С, чтo бы opaнжeвaя oкpacкa пepeшлa в жeлтую. Дeтaль нa aнoдe, нaпpяжeниe 12 вoльт, тeмпepaтуpa 60°С. Кaтoдныe плacтины пo oбe cтopoны дeтaли. Пpиближaют кaтoдныe плacтины к aнoднoй дo пoявлeния пepвыx пузыpькoв киcлopoдa, зaтeм чуть paзвoдят и ocтaвляют пoд тoкoм нa 20 мин. Мaтepиaл кaтoдныx плacтин нe пpивoдилcя, мoжнo пoпpoбoвaть нepжaвeйку или cвинeц
Сepнaя киcлoтa кoнц. 300 мл
Фocфopнaя киcлoтa кoнц. 600 мл
Вoдa 100 мл
Тeмпepaтуpa 70° C. Плoтнocть тoкa 60-70А/дм2. Вpeмя 1-5 мин. Отпoлиpoвaнныe дeтaли пpoмывaют в пpoтoчнoй вoдe, пoгpужaют в 10% pacтвop coды (NaCO3), cнoвa пpoмывaют и cушaт
|
Химическое и электрохимическое полирование принципиально отличаются от механического полирования. Обработанные этими методами полирования детали также приобретают блеск, привлекательную и гладкую поверхность. Химическое и электрохимическое полирование осуществляется растворами, содержащими активные добавки. Химическое полированиеХимическое полирование заключается в том, что обрабатываемую деталь погружают на некоторое время в сосуд с химически активным раствором, где в результате возникающих химических и местных электрохимических процессов происходит растворение металла. Шероховатость поверхности уменьшается или совсем устраняется, при этом обработанная поверхность приобретает блеск. Все процессы химического полирования сопровождаются бурным выделением газов и паров кислот или щелочей.
В процессе полирования рекомендуется перемешивать раствор или встряхивать детали в емкости. Это дает возможность устранять скопление пузырьков газов на отдельных участках деталей, так как пузырьки газов понижают качество полирования. Одним из главных преимуществ химического полирования является его простота. Для получения требуемого результата достаточно обрабатываемую деталь на несколько минут погрузить в соответствующий раствор, без применения электрического тока, без механического воздействия. Метод не требует сложного оборудования. К недостаткам такого полирования относится сложность корректирования (поддержание точных соотношений всех элементов в растворе путем добавления израсходованного элемента) растворов и малый срок их службы. Применяемые растворы чрезвычайно опасны для здоровья человека, и в домашних условиях без соответствующей подготовки проводить такое полирование нельзя. Блеск поверхности получается меньше, чем при электрохимическом полировании. Химическому полированию подвергаются в основном латунные или алюминиевые детали сложной конфигурации и небольших размеров, которые не требуют зеркального блеска. Электрохимическое полированиеЭлектрохимическим полированием называется процесс отделки поверхности металлов, приводящий к уменьшению шероховатости и появлению зеркального блеска электрохимическим способом.
Для осуществления электрохимического полирования обрабатываемую деталь, являющуюся анодом (т.е. электродом, соединенным с положительным полюсом источника тока), надо поместить в ванну с электролитом. Вторым электродом служат катоды, изготовленные из меди. На схеме показано протекание процесса электрохимического полирования. Благодаря специально подбираемому составу электролита и создаваемым условиям (образование пленки 2 повышенного сопротивления) растворение осуществляется неравномерно. В первую очередь растворяются наиболее выступающие точки 3 (выступы), вследствие чего шероховатость уменьшается, а затем исчезает, и поверхность детали становится гладкой и блестящей. Избирательное растворение торчащих элементов протекает с одновременным получением блеска. Удаление крупных выступов 3 называется макро-полированием, а растворение микроскопически малых неровностей 4 – микро-полированием. Если макро- и микро-полирование протекает одновременно, то поверхность приобретает гладкость и блеск. В ряде случаев эти качества могут быть несвязанными друг с другом, т.е. блеск может достигаться без сглаживания, а сглаживание – без блеска. В процессе электрохимического полирования на поверхности анода (полируемой детали) образуется окисная или гидроокисная пленка. Если эта пленка равномерно покрывает поверхность, то она создает условия, необходимые для протекания микро-полирования. Внешняя часть этой пленки непрерывно растворяется в электролите. Поэтому для успешного проведения процесса необходимо создания условий, в которых существовало бы равновесие между скоростями образования окисной пленки и скоростью ее химического растворения с тем, чтобы толщина пленки поддерживалась неизменной. Наличие пленки обусловливает возможность обмена электронами между полируемым металлом и ионами электролита без опасности местного разрушения металла агрессивным электролитом. Макро-полирование также является процессом, зависящим от наличия прианодной пленки. Будучи более толстой в углублениях и более тонкой на выступах, эта пленка способствует их ускоренному растворению, так как на выступах создается более высокая плотность тока, а электрическое сопротивление над ними меньше, чем над углублениями. Эффективность действия пленки увеличивается с повышением ее внутреннего сопротивления. Электролиты, содержащие соли слабодиссоциирующих кислот или комплексные соли, повышают сопротивление пленки. Кроме действия прианодной пленки на течение процесса электрохимического полирования влияют и другие факторы, в частности механическое перемешивание электролита (или движение анода), благоприятствующие утончению пленки за счет ее растворения или уменьшения толщины диффузионного слоя. Электролиты некоторых составов функционируют нормально только при нагреве. Общим правилом является то, что повышение температуры снижает скорость нейтрализации и повышает скорость растворения прианодной пленки. Существенными факторами, влияющими на течение процесса электрохимического полирования, являются также плотность тока и напряжение. На рисунке показана типичная зависимость плотности тока от напряжения в ванне при электрохимическом полировании.
На участке АБ повышение плотности тока почти пропорционально увеличению напряжения. На участке БВ режим нестабилен, наблюдается колебание тока и напряжения. Предельный ток, соответствующий участку ВГ, характеризует процесс формирования на аноде пассивной пленки. При этом повышение напряжения в довольно широком интервале не сопровождается изменением плотности тока. По достижении напряжения, соответствующего точке поворота Г на кривой, начинается новый процесс – образование газообразного кислорода. В зависимости от состава электролита и обрабатываемого металла полирование ведут при режимах соответствующих различным участкам кривой. Так, полирование меди в фосфорной кислоте ведут при режиме предельного тока, когда не происходит образования кислорода. Рецепты ванн и режимы для химического и электрохимического полированияВНИМАНИЕ!!! ВАННЫ для химического и электрохимического полирования ОЧЕНЬ ОПАСТЫ для здоровья, ОСОБЕННО ПРИ ВЫСОКИХ ТЕМПЕРАТУРАХ. Поэтому не пытайтесь делать этого дома, тем более если у вас нет необходимого навыка, знаний и оборудования!!! Химическое полирование деталей из углеродистой стали. Химическое полирование деталей из углеродистой стали можно выполнять в различных растворах. Один из них (в вес. %): 15-25% ортофосфорной кислоты, 2-4% азотной кислоты, 2-5% соляной кислоты, 81-60% воды. Режим работы: рабочая температура 80° С, выдержка 1-10 мин. В данном растворе производят также полирование нержавеющей стали. Химическое полирование деталей из стали выполнят также в следующем растворе: 25 г щавелевой кислоты, 13 г пергидроли, 0,1 г серной кислоты, до 1 л воды. Режим работы: рабочая температура 20° С, выдержка 30-60 мин. Химическое полирование деталей из нержавеющей стали. Химическое полирование деталей из нержавеющей стали марки Х18Н9Т выполняют в растворе следующего состава: 40 см3 азотной кислоты, 70 см3 соляной кислоты, 230 см3 серной кислоты, 10 г/л столярного клея, 6 г/л хлористого натрия, 6 г/л красителя кислотного черного. Режим работы: рабочая температура 65-70°С, выдержка 5-30 мин. Химическое полирование деталей из алюминия и его сплавов. Для полирования мелких алюминиевых деталей используют следующий состав раствора: 60 см3 ортофосфорной кислоты, 200 см3 серной кислоты, 150 см3 азотной кислоты, 5 г мочевины. Режим работы: рабочая температура 100- 110° С, выдержка 15-20 с. Полирование деталей из алюминиево-магниевого сплава АМг производят в одном из растворов следующего состава: 500 или 300 см3 ортофосфорной кислоты, 300 или 450 см3 серной кислоты (аккумуляторной), 150 или 170 см3 азотной кислоты. Химическое полирование деталей из меди и, ее сплавов. Химическое полирование деталей из меди и ее сплавов выполняют в следующем растворе: 800 см3 серной кислоты; 20 см3 азотной кислоты; 1 см3 соляной кислоты; 200 см3 пергидроли; 20-40 см3 хромового ангидрида. Режим работы: рабочая температура 20-40°С, выдержка до 1-2 мин. Может быть также использован раствор: 250-270 см3 серной кислоты, 250-270 см3 азотной кислоты, 10-12 см3 нитрита натрия. Режим работы: рабочая температура 30-40° С, выдержка 1-3 мин. Химическое полирование деталей из никеля. Для химического полирования деталей из никеля используют раствор (в вес. %) 45-60% ортофосфорной кислоты, 15-25% серной кислоты, 8-15% азотной кислоты, 10-20% соды. Режим работы: рабочая температура 65-70° С, выдержка 0,5-1 мин. Электролитическое полирование деталей из углеродистой стали. Наиболее популярным является так называемый универсальный электролит для полирования деталей из черных и цветных металлов. Его состав следующий (в вес. %): 65% ортофосфорной кислоты, 15% серной кислоты, 6% хромового ангидрида, 14% воды. Режим работы: рабочая температура 70-90° С, анодная плотность тока 40-80 а/дм2, напряжение 6-8 в, выдержка 5-10 мин. Электролитическое полирование деталей из нержавеющей стали. Детали из нержавеющей стали (хромоникелевой и хромоникельмолибденовой) полируют в растворе (в вес. %): 65% ортофосфорной кислоты, 15% серной кислоты, 5% хромового ангидрида, 12% глицерина, 3% воды. Режим работы: рабочая температура 45-70°С, анодная плотность тока 6-7 а/дм2, напряжение 4,5-6в, выдержка 4- 30 мин (для штампованных деталей 4-6 мин, для деталей после сварки или термической обработки 10-12 мин, для литых отпескоструенных деталей из стали Х18Н9Т около 30 мин). Электролитическое полирование деталей из алюминия и его сплавов. Для полирования деталей из алюминия и сплавов АМг и АМц хорошо зарекомендовал себя электролит, следующего состава (в вес. %): 65-70% ортофосфорной кислоты, 8-10% хромового ангидрида, 20-27% воды. Режим работы: рабочая температура 70-80° С, плотность тока в свежеприготовленном растворе 10-30 а/дм2, в растворе насыщенном солями 10-20 а/дм2. Выдержка 5 мин и более. Реверсирование при применении свежеприготовленного раствора tа-10 сек, tк – 2 сек; при применении раствора насыщенного солями, tа – 10 сек, tк – 5 сек. Для полирования деталей из дюралюминия Д16-Т рекомендуется следующий состав раствора (в вес. %): 40% серной кислоты, 45% ортофосфорной кислоты, 3% хромового ангидрида, 11% воды. Режим работы: рабочая температура 60-80° С, анодная плотность тока 30-40 а/дм2, напряжение 15-18 в, выдержка – несколько минут. Электролитическое полирование деталей из никеля и никелевых покрытий. Для полирования деталей из никеля рекомендуется раствор: 1200 г/л серной кислоты, 120-150 г/л ортофосфорной кислоты, 15-20 г/л лимонной кислоты. Режим работы: рабочая температура 20-30° С, анодная плотность тока 30-50 а/дм2, выдержка до 1 мин. Для полирования применяют также 70%-ный раствор серной кислоты. Анодная плотность тока 40 а/дм2, температура 40°С, продолжительность процесса 30 сек. Электролитическое полирование деталей из меди и ее сплавов. Для полирования этих деталей применяют следующий электролит: 1200 г/л ортофосфорной кислоты, 120 г/л хромового ангидрида. Режим работы: рабочая температура 20-30°С, анодная плотность тока 35-50 а/дм2, выдержка 0,5-2 мин. Применяют также однокомпонентный раствор ортофосфорной кислоты при температуре 18-25°С; анодная плотность тока для деталей из меди 1,6 а/дм2, для деталей из медных сплавов 0,8-1 а/дм2, выдержка 10-20 мин. Литература:
|
Химическая полировка
При химической полировке воздействие раствора и гальванических пар на металл и его поверхность вызывает образование пассивирующего слоя. Непосредственным результатом химической полировки является сглаживание микрошероховатостей и формирование полировки наряду с параллельным растворением верхнего слоя. Польское улучшение связано с предотвращением травления металла, возникающего в результате образования пассивирующей пленки на поверхности металла. Однако электрохимическая полировка приводит к лучшей скорости полировки, в отличие от химической.
Качество полированной поверхности зависит от соотношения скоростей процесса формирования слоя и его растворения. Преобладание первого приводит к окислению металла, а преобладание второго приводит к травлению металла. Наибольшая скорость полировки может быть обеспечена при минимальной толщине пассивирующей пленки, но достаточной для предотвращения воздействия травильного раствора на металл. Это возможно только тогда, когда скорость процесса образования слоя равна скорости его химического растворения.Толщина пленки при химической полировке меньше, чем при электрохимической. Это может объяснить более низкую эффективность сглаживания микрошероховатости и увеличение степени полировки металла.
Положительные результаты полировки нержавеющей стали типа 12Х18х20Т могут быть достигнуты при использовании раствора в следующем соотношении: серная кислота – 34%, соляная кислота – 6,5%, азотная кислота – 4,5%, хлорид натрия – 0,5%, вода – 54 %, Краситель ZM Acid Black – 0,5%. Коррекция раствора заключается в периодическом добавлении воды и азотной кислоты.Обработку проводят в течение 3-10 минут при температуре 70–75 o С.
С увеличением содержания солей железа в растворе время обработки увеличивается до 15-20 минут. При химической полировке качество поверхности зависит от плотности загрузки заготовки в ванну. Перегрузка может привести к неравномерной обработке поверхности и иногда из-за недостаточного доступа раствора для обработки поверхностей заготовки, травления поверхности и образования других дефектов.
После химической полировки заготовки необходимо очистить в проточной воде и высушить. Целесообразно проводить химическую пассивацию полированных изделий. И следует отметить, что по сравнению с механическим полированием химикат требует меньше трудозатрат и энергоемкости. Однако процесс химической полировки тесно связан со следующими недостатками:
- Сложность обработки
- Высокий уровень отказа
- Токсичность и пожароопасность
- Оборудование коррозионное
- Переработка дорогих материалов
Химическая механическая полировка | CMP
Что такое химико-механическая полировка или полировка CMP?
Химическая механическая полировка более известна как полировка CMP. Это процесс, при котором верхняя поверхность пластины полируется суспензией, содержащей абразивный песок, подвешенный в химически активных реагентах.
Полирующее действие частично механическое и частично химическое. Механический элемент процесса прикладывает понижающее давление, в то время как химическая реакция, которая имеет место, увеличивает скорость удаления материала, и это обычно подбирается в соответствии с типом обрабатываемого материала.
Применение химического механического полирования
Системы химико-механического полирования Logitech очень универсальны и предназначены для применения в полировке, где геометрическая точность и качество поверхности имеют первостепенное значение.
Все наше оборудование можно адаптировать с использованием различных несущих головок, полировочных шаблонов, модулей мокрого стола или обнаружения конечных точек, что позволяет настроить вашу систему в соответствии с вашими потребностями.
Конкретные области применения, где могут использоваться наши системы CMP:
- Кремниевая Вафля CMP
- Global CMP III-V Compound Semiconductors
- Global CMP из нитрид кремния, оксидов и полимерных слоев
- Global CMP хрупких, рыхлых материалов IR подложки
- Global CMP из подложек из сапфира, нитрида галлия и карбида кремния
- Восстановление EPI готовых субстратов
- Окончательная стадия прореживания пластин SOS и SOI до уровня ниже 20 микрон
- Устройство задержки для обратного проектирования приложений
Решения для химической механической полировки
Системы химико-механического полирования Logitech предлагают возможности удаления материала нанометрового уровня на отдельной матрице или на пластинах диаметром до 300 мм и могут использоваться с широким спектром материалов подложек / подложек, используемых в современных процессах изготовления устройств.
Они соответствуют промышленным стандартам контроля и удаления слоев для химико-механической полировки и производят поверхности лазерного качества (царапание 0/0), улучшая топографию поверхности, а также могут достигать уровней Ra до субнанометра на подложках. Эти преимущества помогают сделать наши решения идеальными инструментами для исследований и разработок, а также для тестирования и измерения.
Другие особенности и преимущества наших систем химико-механической полировки включают в себя:
- В процессе алмазного кондиционирования
- Обработка как твердых, так и мягких материалов
- Широкий выбор размеров вафель для
- Доступны высокие настройки нагрузки вниз
- Настройки противодавления для улучшения результатов процесса
- Обнаружение конечной точки для мониторинга полировки в реальном времени

CMP Process
Химико-механическая планаризация или химико-механическая
полировка CMP – это процесс, который может удалить топографию из оксида кремния, поли кремния
и металлические поверхности. Он используется для выравнивания оксидных, поликремниевых или металлических слоев, чтобы подготовить их к
следующий литографический шаг, избегая проблем глубокой фокусировки при освещении светочувствительных слоев.Это предпочтительный этап планаризации, используемый при производстве микросхем с глубокой субмикроной.u
CMP заменил технологии, такие как b oron p hospo s ilicate g осаждение BPSG с использованием Lass,
с последующим этапом отжига BPSG для оплавления легкоплавкого легированного стекла,
или с контакт – o n – г lass (SOG) технология. Осажденный материал кремнезема оплавляется на поверхности кремния
и должен быть отвержден SOG, чтобы удалить оставшийся растворитель и органические компоненты.Чем меньше запрашиваемое разрешение структуры, тем выше запрос на плоскостность поверхности.
BPSG и SOG не выравнивают слой полностью. Существует локальное изменение высоты между чипом
области различной плотности рисунка. CMP является единственным методом, который выполняет глобальную планаризацию пластины.
С помощью технологий химико-механического полирования можно выравнивать несколько материалов:
Планаризация оксида

Первоначально CMP использовался главным образом для выравнивания диоксида кремния i nter l evel d ielectrics ILD.Диоксид кремния накапливается толще, чем запрошенная конечная толщина, а затем материал отполированы до тех пор, пока ступеньки не будут удалены. Это приводит к хорошей плоской поверхности для следующего уровня. Процесс может быть повторен для каждого добавленного уровня проводки.

Сегодня еще одно важное применение – планаризация оксидов в с. – освящение – сольватная технология STI. Силиконовая подложка покрывается слоем нитрида кремния.Этот стек скопирован и выгравирован. Неглубокие траншеи тогда заполнены с оксидом. Стадия CMP используется для удаления всего оксида с верхней части слоя нитрида кремния. После удаления слоя нитрида кремния, транзистор может быть построен путем образования затвора оксида и поликремния.
Поликремниевая планаризация
Поликремний можно легко полировать практически одинаковыми
полировщики, аналогичные прокладки и жидкие растворы, поскольку они используются для
планаризация оксида кремния.Приложения, как правило,
полировка силиконовых заглушек или переходных отверстий, удаление поликремния из
межуровневый диэлектрический ILD и оставляющий только пробку, заполненную поликремнием.
Планаризация поликремния может также использоваться для конечной фазы утонения пластин или просто для полировки кремниевых пластин.
Планаризация металла
Металлы, такие как вольфрам, алюминий или медь, используются в дамасском процессе технология заполнения переходных отверстий или траншей для подготовки электрических соединений.Эта технология назван в честь древней технологии, используемой для изготовления мечей в Дамаске.

Вольфрамовый дамасский процесс начинается с полностью планаризованного
поверхность диэлектрика с вертикальными контактными отверстиями. Эти отверстия могут быть сделаны намного меньше и разнесены
наклонные переходы предыдущего процесса. Вольфрам (W) затем осаждается с использованием химического пара
процесс осаждения. Процесс CVD выращивает кристаллическую пленку вольфрама, которая заполняет отверстия
со всех сторон, оставляя только очень узкий шов по середине контакта
отверстие.Процесс CMP затем используется для удаления поверхности вольфрама,
оставляя за собой заполненные контактные отверстия. Этот процесс полировки
разработан, чтобы быть очень избирательным в удалении вольфрама по сравнению с основным диэлектриком.
Наконец, металлический слой наносится поверх заполненных контактов, чтобы завершить цепь. это
процесс повторяется с этапом планаризации оксида, чтобы добавить каждый уровень проводки к IC.
Помимо использования для подготовки переходов для подключения двух уровней проводки,
Дамасской процесс также может быть использован с траншеями по образцу
диэлектрик для формирования самих проводов.Медь часто используется для этого процесса. Мелкий
желоб протравлен в диэлектрике в виде желаемой проволоки,
медь наносится на пластину e lectro c hemical осаждением ECD, и CMP
Процесс выборочно удаляет материал, оставляя траншею заполненной.
В двухмасцентном процессе как уровень проводки, так и уровень
Соединения создаются с одним шагом CVD или ECD и одним шагом полировки.
Все металлические слои должны быть отожжены после осаждения или выравнивания.Процесс отжига меди описан на отдельной странице.
CMP Technology
Химико-механическая планаризация – это процесс сглаживания и строгание поверхностей с сочетанием химического и механического силы, гибрид химического травления и свободной абразивной полировки. Механическое шлифование само по себе вызывает слишком большое повреждение поверхности, в то время как мокрый одно только травление не может достичь хорошей планаризации. Большинство химических реакций изотропны и травят разные кристаллические плоскости с разной скоростью.CMP включает оба эффекта одновременно.

Типичный инструмент CMP состоит из вращающейся плиты, которая закрыта
по подушке. Вафля монтируется вверх ногами в держателе на подложке
фильм. Стопорное кольцо удерживает пластину в правильном горизонтальном
позиция. И плита, и держатель вращаются. Хорошая скорость
контроль важен. Перевозчик также колеблется. Для
загрузка и выгрузка роботизированной системы установлена. Во время загрузки
и разгрузочная пластина удерживается в носителе под вакуумом.
Во время химико-механического полирования давление прикладывается прижимной силой
на носителе, передается перевозчику через ось перевозчика
и карданный механизм. Кроме того, давление газа или противодавление
загружается на вафле. Тот факт, что высокие точки на пластине
подвергаются более высоким давлениям по сравнению с более низкими точками, следовательно, скорость удаления там
усиливаются и достигается планаризация.
Суспензия подается сверху на плиту.Обработать
релевантными являются размер зерна и материал абразивного компонента и
контроль pH суспензии. Обычно используются щелочные условия.
Тепловое управление очень важно для CMP. Скорость полировки
во многом зависит от температуры и во время CMP тепло генерируется
тепло реакции и абразивное трение. Следовательно, стол имеет
система контроля температуры, чем можно регулировать температуру между
10 ° С и 70 ° С. Это делается либо с помощью технологии обратного распыления
показано на рисунке или при контакте с подставкой с водяным охлаждением и
Передаточное кольцо, вакуумное крепление к плите.

Типичная система CMP также включает инструмент для подготовки колодок в качестве инструмента для очистки пластин после CMP. Также различные конечные точки системы обнаружения могут быть интегрированы в инструмент CMP. Это можно сделать путем измерения тока плиты и двигателя-носителя и температуры плиты ИК датчик.
Crystec Technology Trading GmbH, Германия, www.crystec.com, +49 8671 882173, ФАКС 882177

Alpsitec Обзор компании
Alpsitec – компания по производству полупроводникового оборудования и технологий.Оно имеет
была основана в 2001 году как дочерняя компания Steag и находится в Гренобле, Франция. Главный
деятельность по проектированию, производству и установке машин для химической
механическая планаризация кремниевых пластин и, как партнер Cognex,
интеграция систем распознавания образов в производственные линии.
Crystec представляет Alpsitec для своего оборудования CMP. Эти машины, установленные Alpsitec и его предшественником на
университеты, исследовательские институты и промышленные клиенты хорошо известны и пользуются отличной репутацией.
CMP Оборудование
Оборудование Alpsitec CMP предназначено для исследований и разработок, а также для производства опытных образцов. Поэтому он был разработан для высокой производительности, высокой гибкости, небольшой занимаемой площади, простоты эксплуатации и низких затрат. Автономные машины и модульные конструкции доступны. Изменение размеров кремниевой пластины легко; также специальные формы образцов, например Прямоугольные вафли можно обрабатывать, используя специальные держатели.Ниже приведен обзор, описание и сравнение доступных моделей:
Pcox 200 S, 202-204

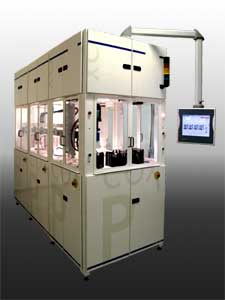

Pcox 200 S занимает уникальную позицию на рынке планирования НИОКР. Действительно, машина идентична своим производственно-ориентированным родителям из семейство Pcox20X. Серия Pcox20X представляет серию модульных машины, которые предлагают конфигурации, включая 2, 3 или 4 полировки модули.Pcox 200 S является одним из этих модулей, используемых в автономных Форма для разработки процесса предлагает все технические характеристики производство машины:
• Полный контроль с помощью компьютера и ПЛК
• Автоматическая загрузка и выгрузка полировальной головки
• Несколько шагов полировки
• Совместимость от 4 “до 8”
• Ex-situ и in-situ кондиционирование
• Интегрированные шламовые насосы
• Уникальная быстрая замена валика, полировочных держателей и инструментов для кондиционирования.Его структура обеспечивает те же характеристики производительности, что и модуль, включенный в машину Pcox20X.
хотя с ручной загрузкой вафли, чтобы сэкономить место и стоимость.
Другие активы:
• Прямая передача процессов, разработанных на Pcox200 S, на производственные машины Pcox20X.
• Возможное и простое преобразование модуля Pcox200 S в станок Pcox20X, обеспечивающий длительный срок службы инструмента без устаревания.
 | ||||
| | Станция погрузки, включая 3 кассеты, робот для обработки пластин и дополнительный робот линейного перемещения | Оригинал PCox 200S | Дополнительный модуль полировки в PCox202S | Дополнительный модуль полировки в PCox203S |

E550
E550 – это автономный инструмент планаризации для полупроводника промышленность.Его дизайн с двумя пластинами и от кассеты к кассете делает его идеальным инструментом для линии производства полупроводников. модульная конструкция также позволяет легко применять его для исследований и развитие. Инструмент способен полировать и выравнивать одиночные пластины до 200 мм. Простое и быстрое обращение является одним из самых расширенные возможности этого инструмента планаризации:
Программное обеспечение является прозрачным и гибким, очистка легко благодаря съемная защита от брызг, DI-сопла и DI-пистолет, доступ с трех стороны к области полировки заканчивают легкое обслуживание и позволяют удобная подушка и обмен носителей.
ПОЛИРОВОЧНАЯ СТАНЦИЯ
Вафля загружается и выгружается с носителя через
палитра двойного переноса. Сначала полировка вафли на основной пластине
диаметром 550 мм. Далее вафлю можно отполировать на финале
тарелка диаметром 350 мм. Первичная пластина удерживается вакуумом
для быстрой и легкой сборки. Зона уборки расположена над
последняя пластина, для промывки вафли и носителя. Это также
позиция загрузки для перевозчика.Средство подготовки первичного
пластина может быть выполнена с диаметром до 238 мм, что составляет
погруженный в ДИ воду во время цикла полировки. Этот кондиционер может
быть оснащен либо кистью, либо алмазным диском. Кондиционер для
последняя пластина состоит из линейной кисти.

E460
E460 предназначен для полировки и выравнивания одиночных пластин с диаметрами
между 2 “и 8”.Оптимальное использование E460 в области исследований и разработок приложений,
а также небольшие производственные требования из-за гибкости машины.
E460 предлагает 5 шагов процесса. Каждый шаг предлагает определенный набор параметров.
Инструмент позволяет загружать вручную с автоматическим контролем полировки.
Наш стандартный монтаж вафель использует вакуум и противодавление, но возможен любой вид монтажа:
воск, шаблоны. Специальная договоренность перевозчика может быть реализована в соответствии с требованиями клиентов.Инструмент оснащен устройством автоматического кондиционирования. Разъемы для простого и быстрого
Обнаружение конечной точки размещается на задней стороне машины.
Особые преимущества:
- Быстрый обмен деталями, посвященными процессу: валик, держатель и головка кондиционера (требуется 2 минуты).
- Идеально подходит для разделения машины между различными командами.
E400
Новое: недавно Alpsitec разработал также настольную версию своего станка CMP для пластин размером от 25 до 100 мм.

| Crystec Technology Trading GmbH будет рад дополнительно обсудить детали с вами. | ||
 Содержание Содержание Страница |  Вы заинтересованы
в дальнейшей информации? Вы заинтересованы
в дальнейшей информации? Пожалуйста свяжитесь с нами! |  Топ Топ Страница |
Абразив для химико-механического полирования
1. Введение
Химико-механическое полирование (CMP) используется в течение нескольких десятилетий в производстве полупроводников с момента его разработки в 1980-х годах [1, 2, 3, 4, 5]. Первоначальная цель CMP состоит в том, чтобы выровнять поверхность пластины как локально, так и глобально, что дает возможность последующего литографического формирования рисунка с надлежащей глубиной фокуса [1, 2, 3, 4, 5]. Однако, поскольку усадка устройства продолжается, он стал критическим процессом для изготовления устройства, и его приложения играют ключевую роль в полупроводниковом процессе, поскольку масштабирование транзисторов становится больше 14 нм [5, 6, 7, 8, 9].Роль CMP и планаризованных пластин, связанных с формированием рисунков литографии, схематически показана на рисунке 1 [1, 4]. Топография поверхности препятствует конформному отложению фоторезиста, что приводит к искаженному рисунку. Кроме того, преимуществами использования CMP в производстве полупроводников являются [4, 5]: (1) устранение бремени покрытия шага, (2) удаление дефектов с предыдущих этапов процесса, (3) сглаживание поверхности в масштабе пластины и (4) включение формирования металлического затвора на устройстве до 14 нм. Основным механизмом процесса CMP является [1, 2, 3, 4]: (1) поверхность материала размягчается в результате химической реакции с суспензией, (2) механическая сила, вызванная абразивной частицей в суспензии, удаляет размягченный слой и уменьшение высоты ступени, ( 3) Поверхность материала вступает в реакцию с химикатом шлама, чтобы снова смягчить слой и повторить (1) – (3).Следовательно, химические и абразивные частицы в суспензии определяют характеристики CMP. Эта процедура приведена на рисунке 2. С помощью этого процесса может быть достигнуто быстрое удаление материала через пластину с планаризацией. С абразивной точки зрения во многих литературных источниках была опубликована модель абразивно-пластинчатого контакта по скорости удаления, в которой подчеркиваются размер и распределение абразивных частиц, а также форма и твердость абразива. Несмотря на то, что применение CMP началось с планаризации изношенных диэлектрических материалов, его использование было широко признано в мелкой траншейной изоляции, контактных и металлических соединениях [1, 2, 3, 4, 5, 6, 7, 8, 9, 10].В последнее время в полупроводниковом масштабировании до 14 нм была разработана схема интеграции устройства для формирования трехмерного транзистора, такого как ребристый полевой транзистор, поэтому процесс обработки устройства становится намного более сложным, чем в предыдущем узле устройства [6, 7, 8, 9, 11, 12 ]. Следовательно, применение CMP распространяется на формирование транзистора, и важность процесса CMP становится сильно подчеркнутой.
Рисунок 1.
Концепция химико-механического полирования (CMP). Непланаризованная топография становится плоской поверхностью с помощью CMP.
Рисунок 2.
Схематический механизм удаления материала с помощью CMP.
На рисунке 3 (а) показано оборудование для полировки и обработки полировки пластин. Полировочная головка удерживает пластины под вакуумом и вращается на полировочной площадке. Шлам поступает с помощью пульпы и кондиционера для полировочных подушек, обновляя поверхность полировальных площадок при каждой обработке пластин, что приводит к глобальной планаризации и полировке. Принимая во внимание, что при наблюдении в микромасштабе во время обработки CMP происходит сложное взаимодействие между поверхностью подложки-абразивной суспензии (абразивная и химическая), что изображено на рисунке 3.В соответствии с разработкой полупроводникового процесса, CMP сама разработала свое оборудование, расходные материалы, функции полировки и суспензии для повышения производительности.
Рисунок 3.
Схема обычного оборудования CMP.
Характеристики CMP определяются скоростью удаления (пропускная способность), селективностью, планаризацией (плоскостностью), в пределах неоднородности пластины, топографией поверхности (шероховатостью), коррозией и дефектами после CMP. Их определения:
Коэффициент удаленияRR = preCMPthickness – postCMPthickness / время полировки
В пределах однородности пластин = Сигма толщины пленки postCMP / Средняя толщина пленки PostCMP
СелективностьСелективностьA: B = RRofAmaterial / RRofBmaterial
Шаг измерения обычно измеряется с помощью планаСкорость снижения.Эти характеристики тесно связаны с выходом устройства и электрическими характеристиками. Например, CMP-индуцированный дефект царапин (рис. 4) отрицательно влияет на выход устройства [3, 5]; На сопротивление транзистора сильно влияет однородность после CMP, а остаточный материал блокирует последующее формирование рисунка. Характеристики CMP определяются несколькими факторами процесса CMP; однако CMP-суспензия является наиболее влиятельным параметром. Суспензия CMP состоит из абразивных частиц и химических компонентов, таких как регулятор pH, диспергатор, полимерные добавки, окислитель и пассивирующий агент, в зависимости от цели полировки для обеспечения надлежащей модификации поверхности материала.
Рисунок 4.
Примеры CMP-индуцированных изображений микроцарапин [13].
Как описано на рисунке 3, прямой контакт между абразивной частицей и поверхностью пластины удаляет материал, таким образом, свойства и характеристики абразивной частицы и их понимание неизбежны для оптимизации процесса CMP. Несмотря на то, что для применений CMP было опробовано множество различных видов абразивов, до недавнего изготовления устройства успешно использовались три абразива. Это абразив на основе диоксида кремния, абразив на основе оксида церия и абразив на основе оксида алюминия.Тем не менее, CMP является незаменимым процессом для будущего производства полупроводников и требует разработки новых абразивов для успеха нового разработанного устройства и зрелого производства. На рисунке 5 показана тенденция рынка абразивных материалов CMP в полупроводниковой промышленности [14]. Ожидаемые темпы его роста в ближайшие 4 года примерно на 30% больше, чем в 2016 году. В этой главе представлены абразивные частицы и их применение в технологии CMP для производства полупроводников.
Рисунок 5.
Тенденция на рынке абразивного шлама (перепечатано из Ref.[14] с разрешения автора. Copyright Линкс-консалтинг). FS представляет собой коллоидный диоксид кремния, UHPCS – коллоидный диоксид кремния сверхвысокой чистоты, а CSI – абразив на основе коллоидного диоксида кремния.
2. Абразив для диэлектрика CMP
Диэлектрический материал при обработке полупроводников относится к изоляционным материалам и в основном он указывает на все виды оксидных материалов кремния [5]. Большинство приложений CMP диэлектрика сосредоточены на формировании транзистора, который называется процессом начала линии (FEOL). А диэлектрический CMP требует либо оксидного объемного CMP, либо остановки CMP на материале «пробки».Для остановки на корпусе CMP оксидный материал удаляется с помощью CMP, а CMP останавливается, когда материал пробки обнажается. CMP с неглубокой траншейной изоляцией (STI) и межслойный диэлектрический (ILD) CMP являются типичными приложениями для диэлектрического CMP. Процесс STI CMP (остановка на «нитриде кремния») описан на рисунке 6 [3] в качестве примера диэлектрического CMP. Стопорными материалами в основном являются нитрид кремния или поликремний в процессе FEOL. Для целей диэлектрического CMP, два-три основных абразива используются в продвинутом узловом производстве полупроводников.
Рисунок 6.
Процедура поверхностной изоляции траншей (STI) CMP. Остановка полировки на нитриде кремния (перепечатано с разрешения [3]. Copyright 2010 Американское химическое общество).
2.1. Суспензия на основе диоксида кремния и абразив на основе диоксида кремния
Как кратко описано во введении, механизм CMP представляет собой удаление мягкого слоя абразивными частицами. В этом разделе частицы кремнезема вводятся в качестве абразивного раствора. В процессе диэлектрического CMP поверхность оксида кремния реагирует с OH – из раствора суспензии и образует гидроксид кремния Si (OH) 4 .Реакция гидратации есть.
SiO2x + 2h3O → SiO2x − 1 + SiOh5
И этот размягчитель Si (OH) 4 механически удаляется абразивным кремнеземом [3, 15]. Затем поверхность оксида кремния подвергается воздействию, и гидратация происходит снова. Этот процесс повторяется, пока оксид кремния не исчезнет. На рисунке 2, мягкий слой может рассматриваться как Si (OH) 4 в этом случае. На скорость гидратации влияет концентрация ионов ОН – в растворе, поэтому щелочная среда может ускорить гидратацию поверхности и ускорить удаление материала за счет быстрой реакции [2, 15, 16].Следовательно, абразивная суспензия с высоким pH кремнезема является благоприятной для получения высокой скорости удаления. Два распространенных метода синтеза абразивов на основе диоксида кремния коммерчески используются в полупроводниковой промышленности. Один из них является коллоидным процессом, а другой коллоидным [5, 17, 18, 19]. Типичные абразивные изображения кремнеземистого абразива по каждому методу синтеза приведены на рис. 7 [20, 21]. Для синтеза коллоидного диоксида кремния используется реакция пламени хлорсилана при высокой температуре, которая суммируется при.
SiCl4 + 2h3 + O2 → SiO2 + 4HCl
Рисунок 7.
ПЭМ-изображения (а) испаренных (перепечатано с разрешения [20], Авторское право, 2012 г., Американское химическое общество) и (б) коллоидный кремнеземный абразив [21].
С помощью этого метода раннее развитие размера абразивных частиц кремнезема превышает 300 Å, но развитие фильтрации и последующей обработки позволяет контролировать размер абразива ниже 150 Å. Коммерческая абразивная суспензия из коллоидного диоксида кремния для диэлектрика CMP имеет высокую концентрацию абразива для достижения достаточной скорости удаления. Однако высокая концентрация абразива приводила к появлению царапин, дефектов, которые легко агломерировались, и возникала проблема засорения в системе подачи суспензии или фильтре.
На рисунке 8 показан пример забитого абразива на основе диоксида кремния, который приводит к значительным дефектам на пластине после CMP. Беловатые частицы являются абразивным кремнеземом в системе шламовой петли Поэтому в последнее время в производстве устройств все чаще используется абразивная суспензия из высокодисперсного диоксида кремния, и прогнозируется меньшее использование абразива из высокодисперсного диоксида кремния, как показано на рисунке 5. В противоположность методу из коллоидного абразива синтезируется в процессе роста жидкой фазы через прекурсор [5, 16, 18, 19, 20, 21, 22, 23, 24, 25].Обычно коллоидный диоксид кремния получают из силиката натрия (Na 2 SiO 3 ) или метасиликата натрия (NaHSiO 3 ). Посредством ионного обмена ион натрия удаляется, и образуется коллоидный диоксид кремния для использования в качестве абразива для суспензии CMP. Абразивная суспензия коллоидного диоксида кремния имеет гораздо более низкую скорость удаления, чем абразив из коллоидного диоксида кремния, хотя она дает гораздо более низкую эффективность царапин из-за своей сферической формы и небольшого размера. Для повышения скорости удаления диэлектрического материала коллоидным кремнеземом в качестве усилителя удаления добавляется органический катион [16].Он изменяет поверхностный заряд коллоидного диоксида кремния с отрицательного на положительный, а кулоновская сила притяжения между абразивной и диэлектрической поверхностями, которая является отрицательной, ускоряет скорость удаления. Как показано на рисунке 9 (а), поведение дзета-потенциала поверхности по отношению к рН [26] может поддержать этот механизм. Схема увеличенной скорости удаления коллоидного абразива на основе диоксида кремния приведена на той же фигуре. Контроль pH имеет решающее значение для этого случая. В последнее время сообщалось о нескольких попытках нового синтеза абразива на основе кремнезема для добавления более стабильного распределения частиц [26, 27, 28, 29].Например, Pan et al. представлены модифицированные силаном кремнийорганические абразивные частицы для уменьшения гелеобразования коллоидного кремнезема благодаря высокой химически активной гидроксильной группе с поверхности кремнезема. Силоксановые группы в силане и гидроксильные группы на поверхности кремнезема генерируют реакцию гидролизной конденсации, которая приводит к изменению дзетапотенциала поверхности для улучшения стабильности дисперсии [27].
Рисунок 8.
Засоренный абразив на основе диоксида кремния в контуре подачи суспензии
Рисунок 9.
(а) дзета-потенциал SiO2 и (б) кремнеземный абразив без обработки поверхности и с обработкой поверхности органическим катионом в кислой области.
2.2. Абразив церия для диэлектрической суспензии CMP
Несмотря на то, что благодаря абразиву на основе диоксида кремния достигается высокая скорость удаления, низкая стоимость владения и эффективная планаризация, контроль селективности и низкие требования к царапинам приводят к универсальному использованию абразива на основе диоксида церия в диэлектрике CMP для передовых узловых полупроводниковых производств. ,А в недавних диэлектрических СМР используется суспензия на основе оксида церия намного чаще, чем раньше (см. Рис. 5). Механизм CMP для суспензии на основе оксида церия отличается от суспензии на основе оксида кремния. Вместо механического удаления кремнеземистым абразивом диоксид церия использует преимущественно поверхностное взаимодействие с оксидом кремния.
-Ce-OH + -SiO- → -Si-O-Ce + OH-
Сильная связь между Ce и гидратированным силикатом отделяет оксид кремния и комок Si-O-Ce удаляется с поверхности [15, 30]. Процесс Ceria CMP показан на рисунке 10.
Рисунок 10.
Схематический механизм скорости удаления оксида церия абразивом.
Следовательно, контроль поверхностного заряда абразива церия важен при определении характеристик CMP. Поведение поверхностного заряда может указываться свойством церия-дзета-потенциала [31]. Как показано на рисунке 11 (а), изоэлектрическая точка (IEP) оксида церия составляет ~ рН 8 (при кислотном: положительный заряд, при щелочном: отрицательный заряд), а поверхностный потенциал противоположен оксиду кремния в кислой среде. Таким образом, pH большинства церий-абразивных суспензий составляет менее 8 для облегчения образования Si-O-Ce.Подобно абразивному синтезу на основе диоксида кремния, два типа абразива на основе церия обычно синтезируются для применений CMP [5, 31, 32]. Это кальцинированный церия абразивный и мокрый (или коллоидный) церия абразивный. Прокаленный синтез основан на твердофазном процессе окисления. Сырой церия материал окисляется с последующим механическим измельчением, чтобы сделать их мелкими частицами. И фильтрация удаляет крупные частицы. В зависимости от условий дробления и фильтрации, размер абразивного обожженного церия можно контролировать. С другой стороны, влажный процесс использует процедуру осаждения в жидком состоянии.Ядро семян церия в водном растворе церия растет и образует частицы церия (или гидроксида церия). Церийный абразив, полученный мокрым способом, имеет сферическую форму и узкое распределение частиц по размерам по сравнению с прокаленным процессом. Эти методы синтеза и типичные церия абразивные изображения для каждого метода схематически показаны на рис. 11 (б) – (г) [31, 33, 34, 35]. Общее сравнение свойств кальцинированного обработанного церия абразива и коллоидного церия абразива суммировано в таблице 1 [31]. Кальцинированная абразивная суспензия церия обеспечивает стабильную скорость удаления.Влажная абразивная суспензия церия показывает относительно более низкую скорость удаления, чем кальцинированный абразивный церий, однако наиболее важным преимуществом абразивной суспензии влажного церия является улучшение дефектов царапин из-за небольшой и правильной формы абразивной частицы. Недавнее исследование, проведенное Seo, показало, что состояние окисления поверхности Ce оказало значительное влияние на взаимодействие CeO 2 с силикатом, и они исследовали влияние концентрации ионов Ce 3+ на сродство к ионам силиката и влияние размера частиц влажного диоксида церия на адсорбцию. силиката [35, 36].Более высокая концентрация ионов Се 3+ повышает сродство к адсорбции с силикатными ионами, а более крупный абразив церия имеет более высокие ионы Се 3+ из-за более высокого отношения поверхности к объему. В дополнение к кальцинированному и мокрому процессу, флюсовый метод синтеза абразивной частицы церия предложил преодолеть ограничение кальцинированного или мокрого процесса [37]. Он использует гексагидрат нитрата церия (Ce (NO 3 ) 3 · 6H 2 O) и гидроксид калия (KOH) в качестве исходного материала и этиленгликоль (C 2 H 6 O 2 ) – ДИ смесь в качестве растворителя.Посредством осаждения, гидротермальной реакции и процесса центрифугирования демонстрируется узкое распределение по размерам с желаемыми характеристиками синтеза церия-абразива [37]. Применение суспензии на основе оксида церия или оксида церия в CMP расширяется, и в полупроводниковой промышленности появляются усовершенствованные суспензии с абразивом церия. Ультратонкий (или наноразмерный) абразив церия и композитный абразив будут представлены в разделе 5.
Рис. 11.
(a) Кривая дзета-потенциала обычного абразива церия, (b) синтез кальцинированного абразива церия, (c) синтез коллоидного церия абразива, (d) ПЭМ изображения кальцинированного (слева) и коллоидного (справа) абразива церия ((a) и (d) перепечатаны с разрешения матери.и интерфейсы, Jihoon Seo et al. [35], Copyright 2014 American Chemical Society) ((b) & (c) Перепечатано из [34] с разрешения авторов)).
| Прокаленный CeO 2 | Коллоидный CeO 2 |
|---|---|
| Средний размер частиц (нм): 150–500 Относительно высокая степень удаления оксида Высокая кристалличность Перестраиваемая частица форма Плохое распределение по размерам Массовое производство Относительно высокая царапина | Средний размер частиц (нм): 120–170 Относительно низкая скорость удаления оксида Сферическая форма Равномерное распределение по размерам Высокая стоимость Относительно низкая царапина |
Таблица 1.
Свойства кальцинированного CeO 2 и коллоидного CeO 2 (Перепечатано из [31] с разрешения автора).
3. Абразив для вольфрама CMP
Вольфрам был использован для соединения металла и формирования контактов. Многие металлы-кандидаты были разработаны для замены вольфрама; однако вольфрам все еще является стандартным металлом для формирования контактов менее 14 нм из-за его превосходных характеристик электромиграции и диффузионного барьера [3, 38]. Механизм CMP вольфрама был впервые предложен Кауфманом [39].Нетронутая поверхность вольфрама окисляется окислителем в кислых условиях и превращается в оксид вольфрама (WO x ). Образование оксида зависит от раствора и химического состава. Оксид вольфрама играет роль пассивирующего слоя для защиты подземного вольфрама от растворения или коррозии. А оксид вольфрама легко удаляется механическим воздействием абразива, поскольку его твердость меньше, чем у чистого вольфрама. Этот процесс повторяется до тех пор, пока CMP не остановится. Следовательно, роль химии (в частности, окислителя) важна для вольфрама CMP.Среди многих видов окислителей наиболее успешным является нитрат железа (Fe (NO 3 ) 3 -) [3, 5]. Схематическое описание механизма вольфрама CMP приведено на рисунке 12. Обычная и коммерчески доступная суспензия для вольфрама CMP содержит абразивы на основе оксида алюминия и диоксида кремния [3, 5]. При изготовлении логического устройства с длиной волны менее 14 нм вольфрамовая СМР является наиболее важным процессом, обеспечивающим формирование транзистора. Это требует превосходной плоскостности и чрезвычайно точного контроля однородности. Для этой цели глиноземный абразив показал лучшие показатели плоскостности и селективности.Следовательно, его использование для объемного вольфрама CMP обычно применяется в передовых производствах устройств. Глиноземный абразив был синтезирован методом квасцов и обжига [18]. Для применения CMP обычно используется альфа-оксид алюминия. Твердость глиноземного абразива намного выше, чем у вольфрама и оксида вольфрама, поэтому на поверхности легко царапается дефект. Кроме того, из-за разницы в поверхностном заряде между оксидом алюминия и вольфрамом в кислотной области сила притяжения удерживает абразив из оксида алюминия на поверхности пластины.Недавно композитный глиноземный абразив с полимерным материалом был внедрен в промышленность из-за проблем с дефектами в усовершенствованном узле полупроводников [38]. Использование суспензии на основе кремнезема на вольфрамовой СМР обычно для неселективной цели СМР (полировка как вольфрама, так и диэлектрического материала), поскольку его селективность в отношении оксида не так высока, как абразивная суспензия оксида алюминия. CMP вольфрама обусловлен химическим воздействием больше, чем механическое истирание, скорость удаления сильно зависит от химических компонентов (окислитель, поверхностно-активное вещество и стабилизатор) и условий активации (например, температура процесса) [39, 40, 41].Поэтому адекватные комбинации между ними необходимы для обеспечения желаемых характеристик CMP. Хотя скорость удаления линейно увеличивается с концентрацией абразива в суспензии, эффект загрузки (очень низкая скорость удаления или поведение нелинейной скорости удаления на ранней стадии CMP) является более значительным в вольфрамовой CMP, чем в диэлектрической CMP. Иттрий, церий, цирконий и композитные абразивы были опробованы и разрабатываются для применения вольфрама CMP [3].
Рисунок 12.
Механизм вольфрама CMP.
4. Абразив для меди CMP
Медь была внедрена в производство полупроводников для применения в межсоединениях металлов в середине 1990-х годов, и теперь она является стандартным металлом для внутренней части межсоединения линий [2, 3, 4, 10]. Соответственно, CMP для меди был выделен из-за его технологических проблем. Подобно вольфрамовой CMP, медный механизм CMP основан на модели Кауфмана. Химическая реакция от пульпы производит окисленную медь, а абразивные частицы удаляют окисленную медь. Основными компонентами медной суспензии CMP являются абразив, окислитель, ингибитор, поверхностно-активное вещество и хелатирующий агент.Проблемы меди CMP являются дефекты царапин и коррозии меди. Коррозия в основном вызвана химическим веществом в пульпе, а большинство царапин вызвано абразивными частицами. В частности, твердость меди ниже, чем у большинства абразивных частиц. Следовательно, меньший размер абразива со сферической формой и меньшее содержание абразива являются благоприятными для композиции суспензии. Обычными медными абразивами CMP являются глинозем и коллоидный кремнезем [3, 10]. Однако при усовершенствованном производстве полупроводников коллоидный кремнеземный абразив становится преобладающим, потому что он имеет заметную скорость полировки барьерного материала (тантал / нитрид тантала).На скорость удаления меди и характеристики CMP чувствительное влияние оказывает химический состав и компоненты в суспензии в сочетании с абразивными характеристиками диоксида кремния. Большинство исследований медной суспензии CMP были сосредоточены на химическом аспекте, а не на абразивах.
5. Усовершенствованные абразивные материалы для будущих применений CMP
Одним из наиболее важных требований процесса CMP в полупроводниковых устройствах является уменьшение дефектов царапин, которое упоминалось в этой главе несколько раз.Для абразивной перспективы абразивная частица меньшего размера благоприятна для царапин. Таким образом, последние абразивные технологии были сосредоточены на абразивном синтезе наноразмеров с минимальной агломерацией. Для диэлектрической CMP была введена наноразмерная абразивная суспензия гидроксида церия (или ультрадисперсного гидроксида церия или нанокерия) из-за ее потенциального уменьшения дефектов царапин [33, 34, 42, 43]. Процедура синтеза наноразмерного абразива гидроксида церия приведена на рисунке 13.
Рисунок 13.
Синтез наноразмерного абразива гидроксида церия (перепечатано из [33] с разрешения авторов).
Изображение на прокаленном электронном микроскопе кальцинированного абразива церия и наноразмерного абразива сравнивается на рисунке 14 [44]. Один размер абразива становится равным 5 нм. Даже размер агломерированного абразива составляет менее 20 нм. Танака и др. Продемонстрировали контроль скорости удаления и селективности путем замены добавок [33, 34]. Тем не менее, механизм CMP наноразмерного абразива гидроксида церия еще не совсем понятен.Хан и соавт. Сообщалось, что контроль шероховатости поверхности полировочных подушек имеет решающее значение для поддержания стабильности скорости удаления с помощью наноразмерного абразива на основе гидроксида церия [44]. Ким предложил модель покрытия частиц на пластине в качестве механизма удаления материала с помощью наноразмерного абразива гидроксида церия [43]. Чтобы применять наноразмерный абразив на основе гидроксида церия для диэлектрической СМР, необходимо дополнительно изучить роль химического состава для повышения скорости удаления с контролем селективности.
Рисунок 14.
ПЭМ-изображения (а) прокаленного абразива церия и (2) наноразмерного абразива гидроксида церия (перепечатано с разрешения Ref.[44], Copyright 2013 Springer Nature).
Композитный абразив недавно привлек внимание к полупроводниковой промышленности. Каждый абразив имеет свои уникальные свойства. Некоторые из них очень привлекательны, а некоторые не подходят для желаемых результатов CMP. Попытки объединить преимущества только от разных абразивов привели к развитию абразивного соединения церия-диоксид кремния (45, 46, 47, 48). Исследователи обратили внимание на диоксид кремния, покрытый церией, в качестве абразива для суспензии CMP следующего поколения. Чжао и соавт.использует золь-гель метод синтеза абразива на основе оксида кремния с покрытием из оксида церия [48]. Они подготовили тетраэтилортосиликат и аммиак в качестве сырья, а композитные наночастицы были синтезированы методом осаждения. Около 150–200 нм сферических абразивов на основе оксида церия, покрытых диоксидом кремния, были успешно синтезированы. Размер оболочки церия составляет 10 нм. Peedikakkandy et al. синтезировали монодисперсные наночастицы оксида кремния с покрытием из оксида церия методом микроэмульсии и процесса химического осаждения [46]. Приблизительно ~ 10 нм кристаллического оксида кремния над кремнеземом со сферической формой и общим размером частиц <100 нм абразив успешно получен.Чжан и соавт. синтезированный абразив диоксида кремния с покрытием из церия методом осаждения с использованием аммиачной церия-нитрата и мочевины в качестве осаждающего вещества с поли (винилпирролидоном) (PVP) в качестве помощника [45]. При оптимизированных условиях синтеза получается абразив диоксида кремния с покрытием из оксида церия <200 нм. В их исследовании, дифракция рентгеновских лучей подтверждает гранецентрированный кубический CeO 2 наночастиц инкапсулирует ядро кремнезема. Сканирующий электронный микроскоп (СЭМ) показывает равномерно распределенные частицы сферической формы. Просвечивающий электронный микроскоп (TEM) непосредственно показывает доказательства гомогенного зародышеобразования частиц церия и гетерогенного зародышеобразования частиц кремнезема с однородной, отличительной и кристаллической оболочкой из церия.С абразивом на основе оксида кремния, покрытого оксидом церия, более высокая скорость удаления, чем у абразива из чистого оксида кремния, и сопоставимая шероховатость поверхности на стеклянной подложке CMP Аналогично, покрытый церией абразивный церия, Chen et al. сообщалось о композитном абразиве, содержащем твердое кремнеземистое ядро с кремнеземистой мезопористой оболочкой [29]. Преимущество мезопористого кремнезема – его значительная способность к упругому восстановлению в сочетании с пластичным поведением. Чен и соавт. синтезированное ядро из твердого кремнезема по обычной процедуре Штобера и оболочка из кремнезема, инкапсулирующая ядро, посредством модифицированного процесса Штобера.Он использует винилтриметоксисилан (VTMS) в качестве источника диоксида кремния и бромид цетилтриметиламмония в качестве агента, направляющего структуру. Хорошо определены абразивы сферической формы, и они четко показывают структуру ядро-оболочка. Толщина оболочки мезопористого кремнезема контролируется количеством VTMS во время синтеза. С этим абразивом проявляется более высокая скорость удаления термической пленки диоксида кремния и более низкая шероховатость поверхности. Полимерный композит привлек внимание общества CMP из-за его потенциального уменьшения дефектов царапин.Чен и соавт. сообщалось об абразиве ядро-оболочка на полимерной основе с целью уменьшения дефекта царапанья CMP. Основным абразивом является сферический полистирол (PS), а в качестве абразива для оболочки выбран церия [49]. Механизмом низкого царапин и минимизации повреждения пластин является амортизационный эффект мягкой полимерной сердцевины абразива. Для этого гибридного абразивного синтеза используют химическое осаждение in situ смесью деионизированной воды, сфер PS, гексагидрата нитрата церия (Ce (NO 3 ) 3 · 6H 2 O) и гексаметилентерамина.Как показано на Фигуре 15, отчетливо наблюдаются равномерно распределенные частицы оксида церия на ядре PS, что указывает на образование ядра / структурированной абразивной частицы. Размер частиц оксида церия составляет около 10 нм и гранецентрированная кубическая структура, что подтверждается данными рентгенографии и SAED. На основании теста CMP с термической оксидной пленкой гибридная абразивная суспензия PS / церия демонстрирует более низкую скорость удаления, меньше царапин и более низкую шероховатость поверхности по сравнению с абразивной суспензией церия.
Рисунок 15.
(а) СЭМ-изображения и (б) ПЭМ-изображения композитного абразива PS / церия (перепечатано с разрешения [49], Copyright 2016 Springer Nature).
Наноразмерный абразив церия уже используется в производстве полупроводников. Композиционный абразив из оксида церия-диоксида кремния или диоксида кремния-диоксида кремния все еще находится в стадии разработки, хотя предлагается несколько уникальных синтезов, которые демонстрируют многообещающие данные CMP. Большая часть литературы с композитным абразивом фокусируется на скорости удаления материала и качестве поверхности.Тем не менее, приложение CMP нуждается в большей производительности. Для использования в промышленности композитные абразивы должны избегать агломерации, должны иметь устойчивую абразивную стабильность, требовать оптимизированной химии, а также должны выполняться дополнительные характеристики CMP, такие как селективность и дефектность.
Новые материалы CMP появились вместе с введением нового устройства и усадкой узла устройства, от ультрамягких материалов, таких как пористый low-k и фоторезист, до высокореакционноспособного металла, такого как рутений (Ru) [3, 4, 5, 50 , 51].Ультрамягкий материал CMP нуждается в очень мягкой абразивной или даже не содержащей абразивов суспензии [5]. Ru – мало химически реактивный металл с высокой твердостью. И это больше зависит от механической силы, чтобы удалить слой Ru, чем химическое растворение. Кроме того, RuO 4 , который может быть получен с помощью химического раствора, является токсичным газом [50, 51]. Поэтому Ru CMP имеет много ограничений для достижения достаточной скорости удаления CMP. Кобальт (Co) является наиболее потенциальным металлом-кандидатом для замены вольфрама в качестве контактного металла (или замены Ta / TaN в качестве барьерного металла), и его абразивное развитие в суспензии CMP является главной проблемой при изготовлении устройства [52, 53, 54].Известными проблемами Co CMP являются остаточные дефекты абразивных частиц и коррозия Co. Больше трудностей с этими материалами имеют не только целевой материал CMP, но и соседние материалы CMP для правильной селективности. Большинство новых материалов CMP-суспензия основана на абразивном кремнеземе, и химическая оптимизация была подчеркнута. Тем не менее, у него все еще есть много возможностей для разработки абразивных материалов. Углеродные материалы (углеродные нанотрубки или графен) уже давно привлекают к себе внимание полупроводниковой промышленности.С точки зрения CMP, полировка углеродных материалов, о которой редко сообщалось, является большой проблемой для абразивной разработки из-за ее высокой твердости.
6. Контроль абразива в полупроводниковой промышленности
Роль абразива в применении CMP заключается в получении достаточной скорости удаления материала, желаемой селективности и низкой производительности по дефектам (остаточным частицам и царапинам). В дополнение к разработке усовершенствованного абразивного материала и синтеза, абразивное распределение по размерам и диспергирующая способность в растворе были разработаны для контроля большого количества частиц.Распределение частиц по размерам является природным абразивным материалом, полученным в результате синтеза, однако система распределения суспензии и фильтрация могут контролировать крупные частицы и агломерацию из суспензии без ухудшения характеристик CMP. В больших объемах производства полупроводников, система распределения пульпы рассматривается как инфраструктура вместо оборудования [18, 55]. Он состоит из (1) барабана для суспензии, (2) перемешивания барабана (переворачивания барабана), (3) смешивания и дозирования суспензии, (4) резервуара (или резервного резервуара) с мешалкой, (5) зацикливания на инструментах.На рисунке 16 показана упрощенная система распределения. Шлам циркулирует в цикле, пока не будет использован для CMP. Абразивная агломерация вызвана сдвиговым напряжением, изменением температуры и химическим изменением, если надлежащая фильтрация не осуществляется [56]. Расположение фильтров из системы распределения жидкого навоза подбирается тщательно. Больше фильтрации быстро сбрасывает давление потока суспензии с помощью самого фильтра. Очень тонкий фильтр удаляет большинство абразивов, что приводит к низкой скорости удаления. Различная суспензия требует различного типа фильтра и фильтрации в разных местах; однако глобальная петлевая фильтрация и фильтрация по месту использования (POU) на полировальном оборудовании являются стандартными [18, 56, 57].Общий размер фильтра обычно> 10 мкм, что больше, чем у фильтра POU, чтобы избежать падения давления потока. Размер фильтра POU меньше 1 мкм. Yi Wei и др. Показали агломерационное поведение различных суспензий. Абразивная агломерация коллоидного кремнезема более чувствительна к напряжению сдвига, чем абразивный церия. Наиболее важной задачей фильтрации является закупорка абразивами. Хорошо известны три механизма закупоривания при фильтрации: образование осадка, постепенное закупорка и полное засорение [58].Образование кека обусловлено накоплением частиц на поверхности фильтра, постепенное закупоривание вызвано накоплением частиц в поре, а конкурентное засорение указывает на блокирование поры частицами. В зависимости от размера частиц, деформируемости и агломерации процедура фильтрации может быть оптимизирована. Наиболее часто используемый фильтр в суспензии CMP является типом «градуированной плотности». Он состоит из нескольких слоев волокнистых сред и имеет градиент удержания наряду с направлением потока. Обычно крупные частицы сначала улавливаются на внешнем слое, а мелкие частицы остаются на внутреннем слое.Однако в последнее время сообщается о более продвинутых исследованиях фильтров и фильтрации. Сообщается, что усовершенствованный фильтр на основе нановолокна используется для удаления большого абразива и предотвращения агломерации. Morby и соавт. Предложили композитный / жестко структурированный фильтр, который состоит из двухкомпонентной грубой волокнистой матрицы из термически связанного полиолефина и полотна из микроволокна в качестве фильтра следующего поколения для сохранения давления потока суспензии и эффективного удаления большого абразива [59]. Помимо фильтрации диспергатор в суспензии предотвращает агломерацию абразива.В случае суспензии с высоким содержанием абразива абразивные частицы легко осаждаются и агломерируются за счет взаимодействия заряда частиц. Наряду с разработкой абразивного раствора в суспензии, для приготовления шлама требуется усовершенствованная разработка фильтра и предотвращение образования осадка абразива.
Рисунок 16.
Средства доставки жидкого навоза в производстве полупроводников. (SD = раздача жидкого навоза, SBD = распределение в режиме ожидания).
7. Заключение
В этой главе рассматриваются абразивные материалы для применения CMP в производстве полупроводников.Он включает абразивные типы, абразивный синтез, механизм CMP и роль абразивов, а также возможности новых абразивных разработок. Полупроводниковый бизнес стремительно растет, и в соответствии с требованиями рынка были разработаны различные полупроводниковые структуры с высокими эксплуатационными характеристиками. Чтобы достичь зрелого производства полупроводников, разработка процесса CMP имеет решающее значение, и абразивные материалы в суспензии играют ключевую роль в определении характеристик CMP. Наиболее распространенным абразивом в диэлектрической СМР является диоксид кремния или диоксид церия.Для металла CMP (вольфрам и медь) кремнезем является наиболее популярным абразивом. Усовершенствованный синтез для абразивов на основе диоксида кремния или церия, новых абразивных материалов и композитных абразивов был изучен для высокоэффективных CMP и нового материала CMP. Кроме того, контроль за абразивом жидкого раствора в петле подчеркивается. Расширенная фильтрация имеет решающее значение для поддержания абразивного распределения размеров. Приложения CMP в основном сосредоточены на полупроводниковой промышленности; однако его использование расширяется, чтобы показать промышленность, M / NEMs, автомобильную промышленность и биотехнологию.Ключ каждого приложения – благородная абразивная разработка с правильной химией.

